PECVD (Plasma Enhanced Chemical Vapor Deposition)
1. plasma
- 물질의 제 4의 상태
- 기체분자에 강력한 에너지를 가하여 전자, 양이온, 중성자로 나누어진 상태
- 높은 전기전도도와 반응성
- 전체적으로는 전기적 중성
챔버내부에 높은 전계를 가해주면 아래와 같은 현상이 일어나며 플라즈마가 생성된다
- Ionization (이온화)
: RF에 의해 가속화된 입자가 다른 원자와 충돌하여 양이온과 전자로 분리됨
분리된 전자는 다시 가속화되어 다른 원자를 이온화
e⁻ + Ar → 2 e⁻ + Ar ⁺
- Dissociation (분리/해리)
: RF에 의해 가속화된 입자가 다른 분자와 충돌하여 Free Radical (홀전자를 가진 원자 또는 분자) 생성
e⁻ + AB → A + B + e⁻

-> 분자 AB는 자연상태에서 공유결합을 형성하고있으나, 가속화된 전자에 의해 분리되어 공유결합이 깨어지고 반응성이 매우 큰 Free Radical을 생성
Free Radical은 반응성이 매우 크기때문에, 쉽게 화학반응을 일으켜서 박막을 생성
2. pressure
- 청정 환경 형성
- 1-100 Torr 저진공
- 공정 모니터링 변수(base pressure(full gas), all gas flow(full open), deposition pressure)
- 압력이 낮으면, 가속된 전자가 기체와 충돌할 확률이 적어져 플라즈마를 만들기 어려움
- 압력이 높으면, MFP가 짧아져 충돌에너지가 낮아 플라즈마를 만들기 어려움
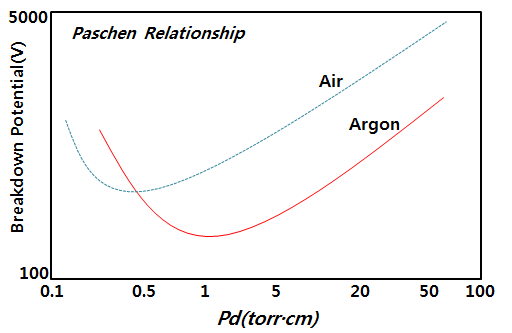
3. gas
- 챔버 내 급격한 압력변화를 막기위해, out put 밸브를 먼저 열어준 뒤, 반응가스를 흘려보냄
- N2 : 화학반응에 참여하는 전구체 가스와 잘 섞여서 챔버 내부에 골고루 퍼지도록 도움 -> N2가 증가할 수록, D/R는 떨어짐
4. 온도
- 낮은 온도
(반응에너지를 온도에서 얻는 LPCVD와 달리, 플라즈마를 이용)
- 반응에너지로 사용되지 않음
- 반응가스의 열분해 및 diffusion에 사용
SiO2 증착
1. 화학반응
- SiH4(g) + 2N2O(g) → SiO2(s) + 2H2(g) + 2N2(g)
2. 공정조건
- 가스유량 : N2 100, SiH4 3, N2O 6 [sccm]
- 공정압력 : 300 mTorr
- 공정온도 : 250 ℃
- 플라즈마 : 100 W
- 공정시간 : 2min
결과
1. ellipsometer 측정결과
| Top | Center | Bottom | Left | Right | |
| thickness [Å] | 1190 | 1179 | 1181 | 1190 | 1182 |
| Avg [Å] | 1184 | ||||
| Uniformity (s/t) | 0.5 % | ||||
| Depo Rate [Å/min] | 592 [Å]/min | ||||
- LPCVD보다 Depo Rate가 빠르다
-> 플라즈마를 이용해 전구체를 반응성이 큰 라디칼로 만들어 막생성
- 한번에 한장씩만 증착할 수 있다
2. 결론
1. 공정변수 중 Pressure의 영향이 크다
-> P가 커질수록 챔버내 반응가스의 확산효과가 줄어들어 uniformity가 나빠짐
2. Plasma
-> 플라즈마 파워가 커질수록 uniformity가 나빠짐
3. LPCVD vs PECVD
| LPCVD | PECVD | |
| 공정온도 | 높다 | 낮다 |
| 반응에너지 | 온도 | 플라즈마 |
| 압력 | 낮다(중진공) | 저진공 |
| s/t | 높다(낮은 압력 -> 청정환경) | LPCVD보다 낮다 |
| * 낮은 압력 → 반응가스의 확산속도가 빠름 → 표면에 도달하여 막을 형성하기 쉬움 → s/t가 좋다 * 높은 온도 → 기판 표면에서의 확산반응 → s/t가 좋다 | ||
| d/r | 느리다 | 빠르다 |
| * 높은 압력 → 반응가스의 양이 많음 → 반응이 빠르게 일어남 -> 박막 성장속도가 빠름 * 반응에너지 | ||
| 특징 | PECVD에 비해 고품질의 박막을 형성할 수 있지만, 높은 공정온도를 필요로 하기 때문에 소자가 손상을 입을 수 있어, 적용할 수 있는 공정이 제한적 | 플라즈마를 반응에너지로 이용하기 때문에, LPCVD보다 공정온도가 낮아 적용범위가 더 넓음 |
* 어닐링
SiO2를 증착한 웨이퍼를 650℃에서 30min 어닐링
-> SiO2 증착 화학반응시, 전구체인 SiH4가 100% 분해되지 않아서 생성된 SiO2 막에 포함된 수소불순물을 어닐링을 통해 제거
'반도체 > Depo' 카테고리의 다른 글
| [Depo] LPCVD vs PECVD 비교 (0) | 2022.06.01 |
|---|---|
| [Depo] 증착공정 비교 - PVD, CVD (0) | 2022.05.10 |
| [Depo] PVD - evaporation, supttuering (0) | 2022.05.08 |
| [Depo] ALD Process (0) | 2022.05.05 |
| [Depo] LPCVD - poly-si 증착 (0) | 2022.05.04 |



댓글